【二次离子质谱如何在半导体行业进行应用?】

文章图片
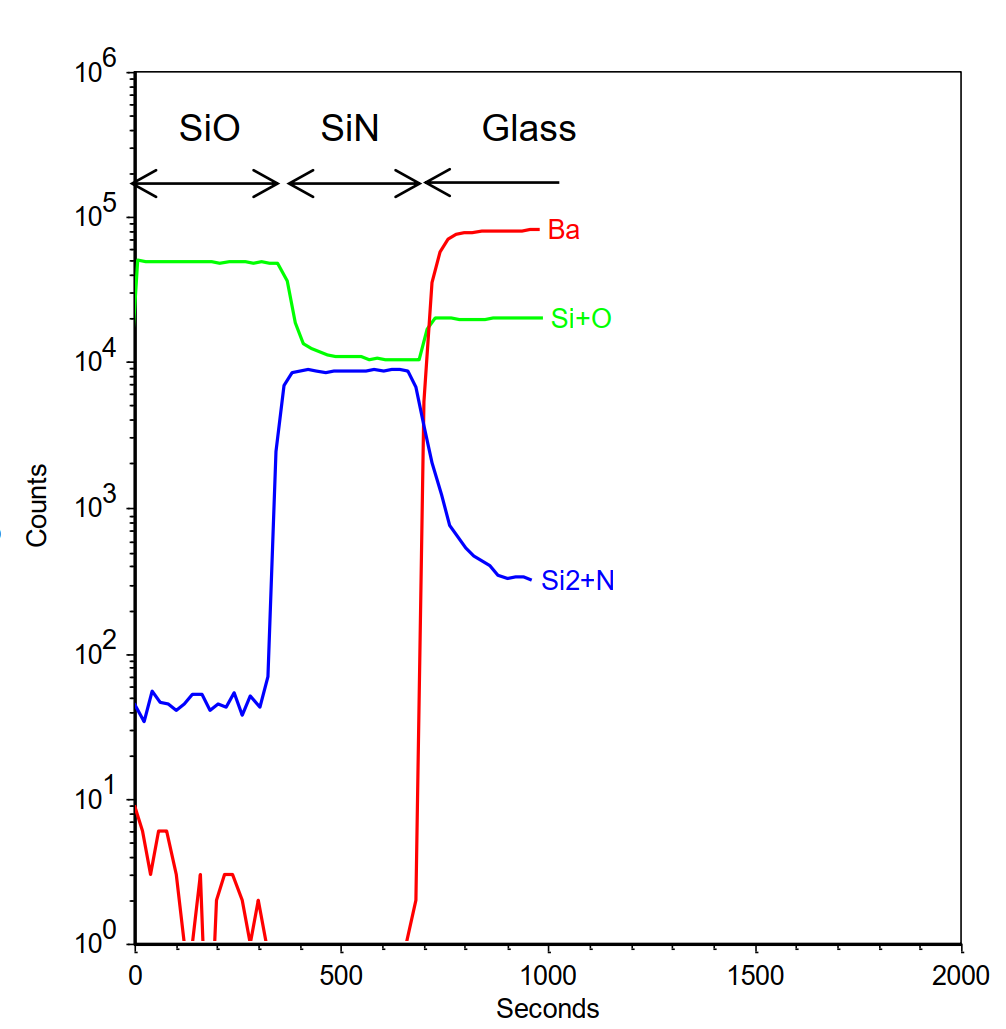
二次离子质谱是利用质谱技术对固体样品表面溅射的二次离子进行检测和分析 , 从而获得表面成分信息的技术 。 所谓溅射是指当具有一定能量(通常为数百至数万EV)的初级离子束轰击固体表面时 , 激发样品表面上某些粒子的过程 。 这些粒子大部分是中性粒子 , 少数是原子、原子团簇和带正负电荷的分子 。 这些带电粒子是二次离子 。
Sims可以检测从氢到铀的所有元素及其同位素 , 元素的检测限可以达到ppm~ppb水平 。 由于溅射二次离子不仅包含原子 , 还包含原子团和分子 , 因此Sims技术可以检测无机和有机物质 。 它已广泛应用于微电子、材料、化学、地质、生物医学等领域 。 配备TOF检测器的二次离子质谱仪是目前表面分析技术中分辨率最高的 。 TOF-SIMS的分辨率可达104 , 深度分辨率可达1nm , 微区分辨率可达100nm2 , 二次离子浓度灵敏度可达ppm 。
根据扫描模式 , SIMS可分为静态(SSIM)和动态(DSIM) 。 SSIMS要求真空<10-7pa , 电子束能量小于5kev , 并以低束流密度轰击材料微区 , 以确保仅激发单层原子以实现超高表面分辨率 。 DSIMS采用高能高密度离子束分层剥离材料 , 同时交替进行高能离子束溅射和质谱检测 , 检测不同深度的二次离子信息 , 动态分析元素在三维空间的分布 。 DSIMS的空间分辨率可以达到亚微米级 。
由于Sims具有很高的灵敏度和空间分布检测能力 , 特别适用于半导体材料的分析 , 如半导体元件的元素掺杂和表面污染等 。 此外 , 在低元素浓度下 , 二次离子的产率与浓度有一定的线性关系 , 因此Sims也可以通过标准样品实现定量分析 。 杭州微源检测的德国离子TOF利用先进的TOF-SIMS仪器测试可以提供完善的SIMS技术解决方案 。 下图是半导体材料薄膜结构的DSIMS分析曲线 。 从图中 , 我们可以看到不同元素和组在材料纵向上的相对变化 。
推荐阅读
- 揭秘陶乐德事件:男子在拘留室离奇消失,难道平行时空真的存在?
- 青藏高原将停止增高,后果不可承受,我们却未感到危机
- 寻求气候变化的确定性:要多少才足够?
- 少见!今年十五的月亮,不是十六圆
- 科学家在大型强子对撞机上寻找难以捉摸的基本粒子
- 地球果真出了大问题?火山爆发后出现神秘现象,科学家紧急发声
- 简述相对论发展史:从伽利略到引力波
- 重磅!英美科学家对奥密克戎病毒11个最新判断!对全球意义重大!
- 15000年前海底金字塔被发现,科学家推测:中华文明前身是MU文明
- 人的气运竟然真的存在?科学家竟然已经证实!







