
文章图片
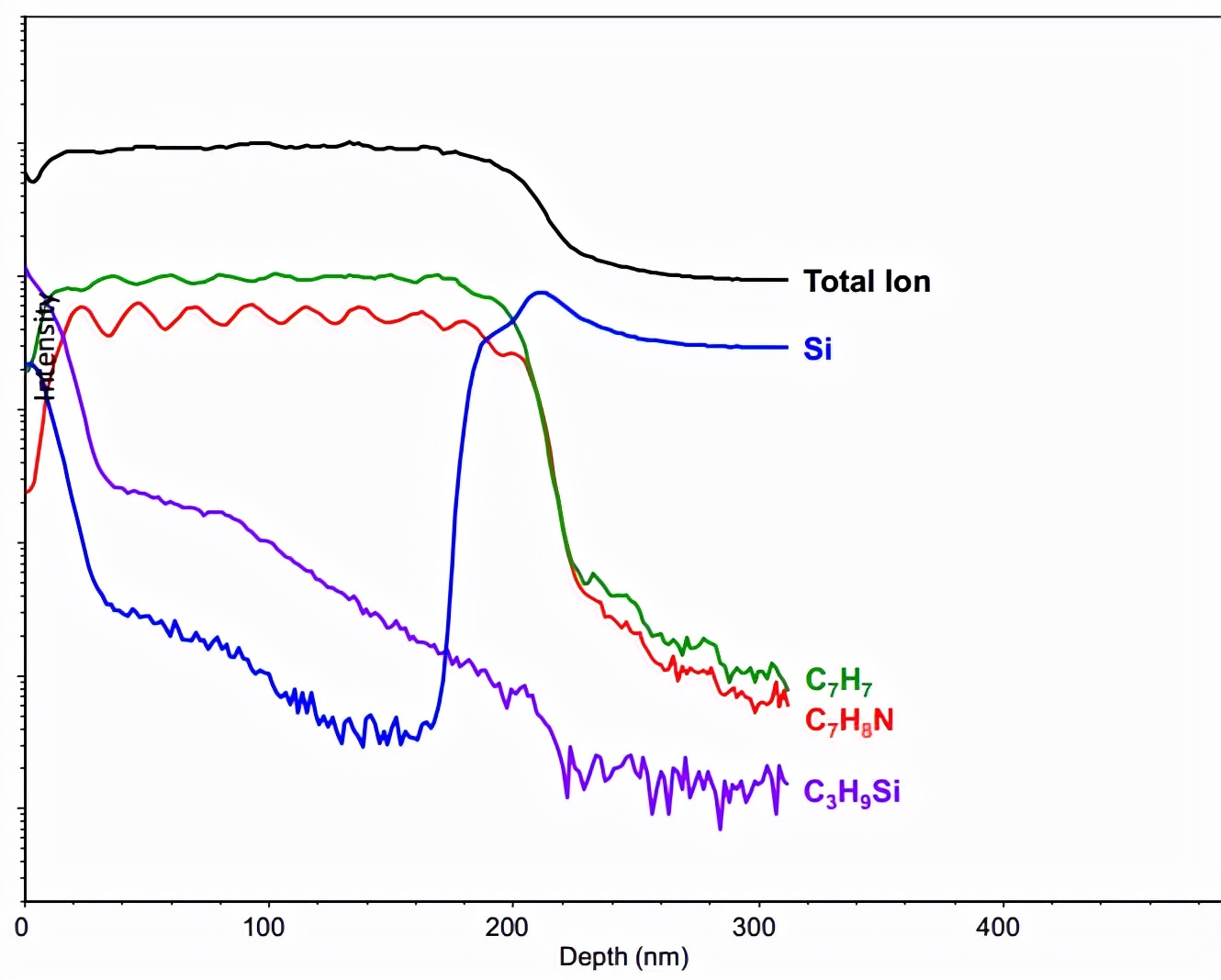
二次离子质谱 , 即SIMS技术具有极高的灵敏度和分辨率 , 它能够分析从H到U的全元素及同位素 , 对一些元素的检出限可以达到ppm~ppb级别 , 是对固体材料表面进行化学分析的重要手段之一 。 利用一定能量的初级离子束入射到样品表面 , 导致表面的粒子发生溅射 ,这些粒子中少部分是带有正负电荷的原子、原子团、分子等 , 被质谱接收后分析得到成分的化学信息是技术的原理 。
通过SIMS技术可以完成二次离子质谱图、深度分析曲线图、表面化学成像等 。 因为表面溅射出的二次离子除了带电原子 , 还会有一些分子离子或分子碎片 , 使得该技术不仅可以用于分析无机物 , 在有机物大分子结构的分析上又有文献研究应用 。 目前该技术已经广泛应用于生物医药、半导体、材料化工等领域 。
【二次离子质谱技术及对材料深度的分析检测应用】二次离子的不同功能主要通过不同的激发离子束的控制来实现 。 使用低能量、低能量密度的离子枪 , 持续稳定地轰击材料表面 , 可以得到样品表面单层原子的二次离子质谱图 。 这种扫描方式被称为静态SIMS(SSIMS) , 对样品的破坏性最小 , 通常可以用于分析难以分析的有机结构或对表面进行化学成像 。 而要完成深度分析功能 , 一般需要使用高能量、高能量密度的初级离子束 , 这种扫描方式被称为动态SIMS(DSIMS) , 动态地剖析材料的元素在三维空间的分布情况 , DSIMS的空间分辨率也可以达到亚微米级别
在SIMS发展的历史中 , 用于检测二次离子的质荷比的检测器有磁质谱仪、四极杆质谱仪、飞行时间(TOF)质谱仪等 。 如今 , 飞行时间-二次离子质谱(TOF-SIMS)是表面分析性能最好、应用最为广泛的二次离子质谱技术 。 微源检测提供德国ION-TOF先进TOF-SIMS仪器检测服务 , 可以提供完善的SIMS技术解决方案 。 下图为某半导体器件的DSIMS深度分析案例 , 从图中可以看出器件表面的多层结构 , 并且可以根据曲线看出Si的信号值在表面存在是来自表面的硅污染 , 而在200nm到达Si基体时出现突变并趋于稳定 。
推荐阅读
- 它被称为“翻版”的地球,上面有山脉和雷雨,生命存在几率非常大
- 血月又临世间,持续时间580年来最长,血月是如何形成的?
- 580年来最长月食上演,全球各地共赏
- 火星上有水吗,证据又是什么?
- 被质疑“挂块肉都比它强”!教科书删除的地动仪,真是伪科学吗?
- “十四五”期间将开放60~70处大遗址
- 旅行者发射44年,还未飞出太阳系,到底咋回事,有神秘力量阻挡?
- 最远人造物已至221.54亿公里外世界,最后的照片中拍到了什么?
- 近600年来最长月偏食于今晚上演







