【适用于清洁蚀刻后残留物的定制化学成分(2)】

文章图片
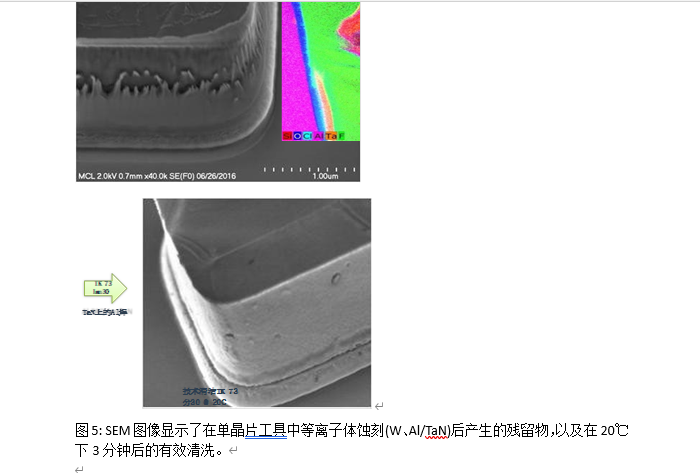
通过小心增加[H2O
来提高蚀刻速率和清洗性能 。 IK 73中基础配方技术的有效性可以通过小心处理三种主要成分的比例来突出 。 在本例中 , 配方调整产生了一种清洁溶液 , 在20°C的温度下 , 经过几分钟的时间 , 与几种不同的金属和阻挡层特征相比 , 该溶液对金属叠层提供了优异的清洁和选择性(图5) 。
结论
传统上 , 氢氟酸在半清洗中的侵蚀性是通过降低其在水中的浓度来控制的 , 稀HF (dHF和dHF+)、BOE和各种基于HF的专有清洗产品的广泛适用性证明了这一点 。
这种新颖的半水配制HF方法看起来可扩展和调整到几乎所有的半导体叠层和互连技术 。 TechniClean IK73基于清洁能力(尤其是对Ta、Hf、Zr基化学惰性残留物的清洁能力)提供了明显的优势 , 对敏感基材如Cu和Al具有高选择性 。 此外 , 该解决方案在非晶和沉积态高K氧化物和金属之间提供了非常高的选择性 , 提高了整体残留物清洗性能、特征清洁度和完整性 。
推荐阅读
- 一朵云可重达500吨,为何它们不会掉下来,而是漂浮在空中?
- 绿牛的恶魔果实推测,动物系、幻兽种、树木子形态
- 人类历史首次发现!“双一流”高校,再发Nature
- 卖淫女假称高校老师,还能提供在校女大学生,一天10单月入30万?
- 蜜蜂之死的启示
- 惊!女大学生穿短裙在操场走秀,有人蹲下偷拍裙底
- 河南女大学生核酸呈“阳性”,学校瞬间炸锅了,感染原因叫人愤怒
- 生物医学工程,是生物科学还是临床医学?这8个专业你误读了吗?
- 江苏一女大学生会反差,身材梨形倒抬篮球架,网友:姐姐有安全感







