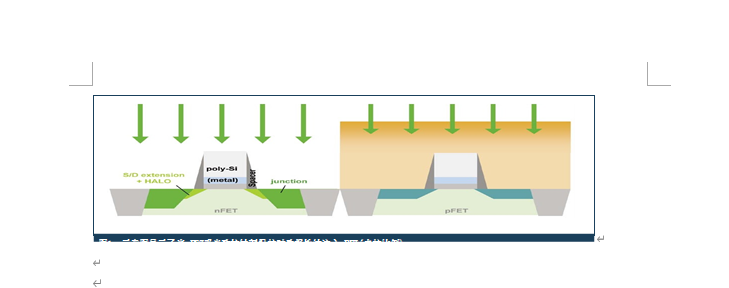
引言
在未来几代器件中 , 光刻胶(PR)和残留物的去除变得非常关键 。 在前端制程(FEOL)离子注入后(源极/漏极、扩展、haIos、深阱) , 使用PR封闭部分电路导致PR实质上硬化且难以去除 。 在后段制程(BEOL)蚀刻中 , 在不去除低k材料的情况下去除抗蚀剂和残留物的选择性是非常具有挑战性的 。 概述了现状、问题和一些新的方法 。
介绍
光致抗蚀剂用于保护晶片的某些区域免受干蚀刻化学物质、离子注入等的影响 。 工艺完成后 , 需要选择性地去除光致抗蚀剂并清洁表面 , 以确保表面没有残留物和颗粒 。 原则上 , 使用湿化学物质如热SPM、有机溶剂或通过使用干等离子体的“灰化”去除抗蚀剂是可能的 。 然而 , 在干法蚀刻或注入处理过程中 , 抗蚀剂会发生化学改性 , 这种改性会显著降低剥离速率 。 如果更具侵略性-例如 , 使用高度氧化的化学物质 , 这可能导致晶片上其他材料的不希望的侵蚀 。 虽然这些考虑几十年来 , 对于单元工艺开发非常重要 , 对于45纳米技术节点和更高技术节点的某些iTRS路线图要求变得越来越严格 , 以至于工业实验室正在考虑对cMOS集成流程的几个模块进行根本性的范式转变 。 同时 , 新的替代集成方案 , 包括使用应变硅、金属硬掩模和金属栅电极 , 导致不同的要求 。 这使得对这一主题的研究更加复杂 。
在下文中 , 我们华林科纳总结了现状、问题和新方法 , 重点关注FEOL中的源漏注入模块和BEOL的低k干法刻蚀模块 。
FEOL:植入后抗蚀剂剥离源极-漏极注入模块场效应晶体管的源极/漏极(S/D)结是通过将掺杂剂离子注入硅衬底而形成的 。 这种注入通常涉及离子as、P、B或BF2的面密度约为 。 1012到几个1015cm 。 离子能量的范围从非常浅的S/D扩展的几100eV到深注入的几十keV 。 为了确保在同一芯片/晶片上制造的各种器件 , 特别是nFETs和pFETs , 每个器件只接受适当的注入 , 需要进行选择性注入 。 这是通过用图案化的光致抗蚀剂进行掩蔽来实现的 , 如图1示意性所示 。 因此 , S/D区域中复杂的掺杂剂几何形状是通过光致抗蚀剂应用和图案化、离子注入、抗蚀剂剥离和表面清洁的循环产生的 。
注入抗蚀剂的离子导致近表面区域的化学改性 。 抗蚀剂聚合物的化学键被来自撞击离子的能量破坏 , 这会导致聚合物主链断裂 。
结论
开发下一代光刻胶剥离剂和残留物去除剂并不容易 。 它来自于大量的辛勤工作和致力于创造一种满足90纳米节点或以下技术需求的化学 。
【华林科纳研究蚀刻后残留物和光刻胶去除】我们最新的化学技术可有效去除low-?电介质上的大块光刻胶、灰渣和抗反射涂层 。 它还是100%水溶性的 , 是一种更加环保的解决方案 。
推荐阅读
- 冰川融化恐释放病毒?不速之客还有更多
- 外星人变成了机器人?英天文学家:千年后,人类也会被机器人取代
- “网红”饮食法再登顶刊!Nature首度揭露:「间歇性禁食」竟可促进神经再生和修复
- 探索奥秘:前NASA科学家称40年前可能就已发现火星有生命
- 一个月6000万吨,人类排泄物是如何变为清水的?这要从冲水说起
- 距离人类最遥远的“尼莫点”,会是动物的天堂吗
- 清华团队:在蚊子眼里,你为什么格外美味?
- 都是哺乳动物,为何人死后会很快发臭,而猪肉羊肉不会那么快?
- 天敌,不好意思,对于它们五个这个词语是不存在的







