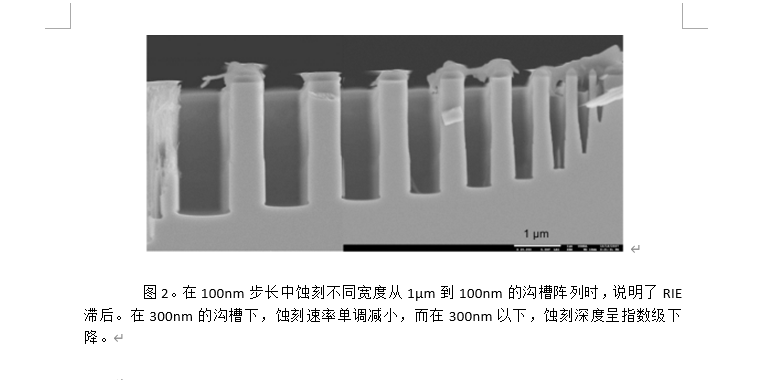
文章图片
关键词:反应离子刻蚀 , 加载和滞后效应 , 微掩膜 , 氮化镓 , GaAs , 磷化铟 , 纳米光子学
摘要
本文将描述反应离子刻蚀技术的一般方面 , 如各向异性、负载效应、滞后效应、反应离子刻蚀化学和微掩模 , 然后简要概述刻蚀电介质(二氧化硅、氮化硅)和晶体硅 。 论文的第二部分致力于蚀刻ⅲ-ⅴ族化合物半导体 , 其中基于氮化镓材料的反应离子刻蚀结果 , 揭示了一种简单实用的热力学方法 , 解释了选择蚀刻特定材料的最佳化学物质的标准 , 并解释了氮化镓蚀刻结果 。 最后 , 将讨论使用各种化学物质蚀刻磷化铟基材料的综合研究 , 以及它们的各种光子应用 。
介绍
等离子体蚀刻、干法蚀刻和反应离子蚀刻(RIE)都描述了处理技术 , 这些技术具有共同的第四种物质状态:等离子体 , 也称为材料的电离状态 。 等离子体状态描述了一种情况 , 其中一种或多种气体被保持在一定的压力下 , 并被施加电势 , 导致气体原子的部分电离[1
。 在等离子体中 , 正离子、自由基和电子共存 。 大约30年前 , 大多数半导体器件的工业工艺严重依赖湿法蚀刻技术;然而 , 等离子体工艺 , 更具体地说是RIE , 逐渐取代了湿法蚀刻技术 。 这是因为它们具有优异的均匀性、可重复性 , 更重要的是 , 随着允许批量处理的设备的出现 , 它们具有高产量 。
文献中已经广泛报道了干法蚀刻的主题 , 并且涵盖了跨越电介质(氧化物和氮化物)、聚合物、半导体材料甚至金属的各种化学和材料 。 本文旨在提供一种实用的方法来解决与各种材料的等离子体蚀刻有关的问题 。
反应离子刻蚀的一般方面滞后效应:RIE滞后效应是对特征尺寸导致的蚀刻深度差异的限定 。 例如 , 当通过掩模中不同的开口尺寸进行蚀刻时 , 与较小尺寸的开口相比 , 大的开口区域中的蚀刻深度可以大得多 。 这种不均匀蚀刻与蚀刻反应物和产物进出蚀刻孔的扩散过程有关:尺寸越小 , 反应物到达孔底部所需的时间越长 。 类似地 , 蚀刻产物向外扩散需要更长的时间 。 图2很好地说明了这种反应离子刻蚀滞后效应 , 显示了一个使用Cl2 :Ar:H2刻蚀磷化铟的电感耦合等离子体反应离子刻蚀工艺的扫描电镜照片 。 图案由宽度从1米到100纳米的直线(沟槽)组成 , 以100纳米的步长变化 , 沟槽之间的间隙也相应变化 。 值得注意的是 , 最小开口处(300纳米及以下)蚀刻深度的减少是显著的 。
CCP和电感耦合等离子体系统中的直流偏置:在电容耦合(CCP)反应器中 , 当产生一定的放电时 , 施加到下电极的射频功率与所谓的直流偏压直接相关:在与离子电荷和电极电势成比例的撞击能量下 , 负电势响应或吸引位置到电极 。 当增加射频功率时 , 等离子体变得更致密 , 直流偏压也增加 。 因此 , 在这种反应器中 , 等离子体密度与较高的直流偏压相关 , 从而产生较高的离子轰击 。
干蚀刻中的各向异性 , 负载作用 , 微掩蔽 , 化学选择 略
硅、二氧化硅和氮化硅的干法刻蚀
硅、多晶硅和无定形硅、二氧化硅和氮化硅通常在氟基化学中被蚀刻 , 其中蚀刻产物主要是挥发性的四氧化硅 。 因此 , 在这些材料中可以获得相当好的蚀刻速率 , 这取决于反应器精确使用化学及其应用 。 根据具体情况 , 可以考虑不同的变化 , 例如用于蚀刻硅的CHF3和SF6 , 其中SF6是主要的化学试剂 , CHF3提供一些钝化 , 实现各向异性蚀刻 。 在这一类别中 , 博世工艺最为人所知 。 它需要两种气体的混合物 , 其中一种确保材料的良好蚀刻 , 而第二种产生钝化层以抑制侧壁蚀刻 。 SF6是选择用于硅的快速蚀刻的气体 , 而C4F8是钝化气体 。 在博世工艺中 , 两种气体交替使用 , 通常SF6在较低压力下运行7–8秒(以产生垂直蚀刻, 而C4F8在较高压力下运行2–3秒 , 以增强侧壁钝化 。 因此 , 后者在晶片水平表面以及蚀刻的侧壁上产生薄保护层 。
ⅲ-ⅴ族半导体的干法刻蚀
氮化镓的干法刻蚀 略
其他ⅲ-ⅴ族半导体的反应离子刻蚀
基于cl2的化学及其子变体 , 用于蚀刻基于砷化镓-、InP-和基于gan的结构 , 用于各种器件应用 。 主要的蚀刻成分是与所有III和V元素发生反应的氯自由基 。 可以根据应用程序考虑许多子变体 。 h2通常作为一种钝化剂添加 , 允许更好的各向异性和更平滑的侧壁 。 这对于蚀刻波导(集成光学和激光器)非常重要 。 或者 , 甲烷也可以添加到氯气:h2组合中进行额外的钝化 , 但这将会减缓蚀刻速率 , 同时恶化对所使用的掩模的选择性 。 另一种替代氯气:h2混合物是添加少量的Ar , 这可以更好地平衡物理蚀刻和钝化 , 从而导致高各向异性和光滑的侧壁 。 当Al是iii元素之一时 , 氯气:甲烷:H2是一种可能性 , 但更常见的是三氯化硼或四氯化硅可以被添加到氯气中 。 另一种常见的组合是氯气:O2 , 这是一种流行的化学方法 , 可以实现phc型模式中的高长宽比 , 其中孔的直径通常在200-300nm的范围内 , 所需的蚀刻深度为3μm或更多 。
推荐阅读
- 地球的岩石,和月球的岩石有相同之处吗?
- ?了解更多关于俘获离子量子计算的详细信息
- 太空温度达零下270摄氏度,为什么太阳光到达地球后反而变热了?
- 在国际空间站中,人类可能受到的伤害
- 中国天眼收到外太空“警告”? 霍金生前或说对一件事!
- 1978年NASA发现金星生命,为何没公布,到底隐瞒了什么?
- 美俄真的做过太空受孕实验吗?失重状态下,对繁衍的影响多大?
- 如果你在3月4日观察天空,也许,将望见一艘火箭的残骸坠入月球
- 未来会出现“新人类”吗?巴瑶族仍在进化,身体同常人有差异
- 雪山发现500年前的少女,面容如生看着像睡着了,死法其实很残忍







