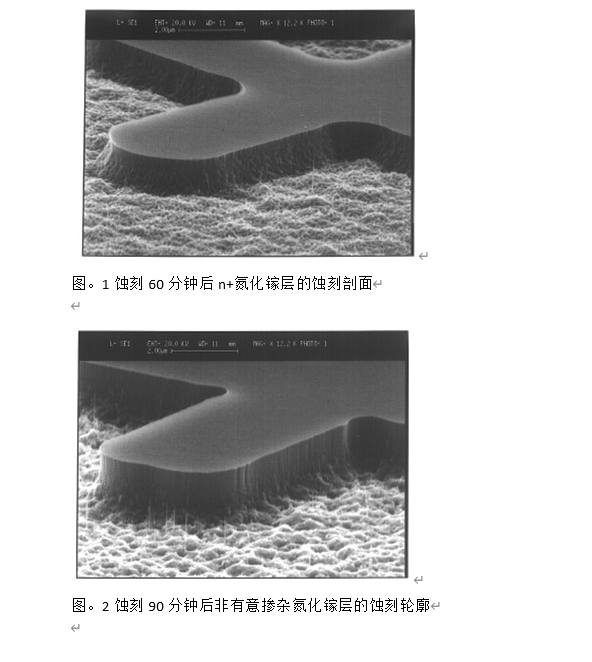
索引术语:氮化镓 , 蚀刻
摘要
本文介绍了我们华林科纳的一种利用氢氧化钾溶液和大面积汞灯照明对氮化镓进行光增强湿法化学刻蚀的工艺 。 讨论了n+氮化镓、非有意掺杂氮化镓和p-氮化镓样品的结果 。
介绍
光电化学蚀刻是一种技术 , 其中材料中电子和空穴的光生增强了材料的化学蚀刻 。 本文已经对各种半导体材料进行了湿法PEC蚀刻研究 , 结果表明 , 湿法PEC蚀刻可以产生高蚀刻速率、良好的各向异性 , 以及不同掺杂和带隙材料之间的高选择性。 明斯基等人 。最近已经证明了在He-Cd激光器(λ = 325nm)的照射下使用KOH和HCl溶液对GaN进行PEC蚀刻的可行性 。 他们展示了非有意掺杂(NID)氮化镓(n = 2–4×1017)的高蚀刻速率 , 使用退火(900℃)钛触点形成电触点和蚀刻掩模 。 在这封信中 , 我们报告了使用汞灯曝光和未退火的沉积钛金属接触在大面积上进行的n+、NID和p型掺杂的氮化镓样品的PEC蚀刻 。
实验
【华林科纳氮化镓的大面积光电化学蚀刻的实验报告】氮化镓样品安装在电化学电池中 , 类似于前面描述的。 使用镀金镍垫圈将样品夹在聚四氟乙烯底座上 。 连接到垫圈的铂丝用作系统阴极 。 对于这些实验 , 在样品和铂阴极之间没有施加偏压 。 将细胞置于室温下充满0.04毫摩尔氢氧化钾溶液的培养皿中 。 曝光是在卡尔·苏斯·MJB-3型掩模对准器中进行的 , 使用的是未经过滤的汞灯源 。 分别在320、365和405纳米的波长下测量到6.4、7.4和13.2毫瓦/平方厘米的强度 。 24小时后 , 在Tencor阶梯轮廓仪的10纳米分辨率范围内 , 每个样品的“暗”蚀刻速率可以忽略不计 。 此外 , 对于没有施加金属接触的氮化镓样品 , 6h后没有观察到明显的蚀刻 。 明斯基等人 。 描述了使用高温退火在钛焊盘和下面的氮化镓之间获得良好的电接触。 这项工作中使用的沉积钛触点没有退火 , 表现出温和的整流特性。 然而 , 金属半导体界面代表用于将电子传导到阴极的正向偏置结 , 并且支持足够的电流以发生明显的蚀刻 。
结果和讨论
图1和图2示出了60°之后n+和NID GaN的蚀刻轮廓分别蚀刻90分钟 。 对于这些图像 , 使用氢氟酸去除钛蚀刻掩模 。 1.2和1.5米的蚀刻深度对应于n+氮化镓的20纳米/分钟和NID氮化镓材料的17纳米/分钟的蚀刻速率 。 图1所示的n+氮化镓样品 。被过蚀刻5小时 , 直到到达衬底 。 观察到蚀刻工艺提供了高的各向异性 , 同时蚀刻掩模的底切最小 。 这些图像中观察到的表面粗糙度可能反映了材料中存在的高浓度缺陷 。
值得注意的是 , 对于p型样品没有观察到明显的蚀刻 。 先前对GaAs PEC蚀刻的研究表明 , 蚀刻速率取决于光生空穴对半导体表面的限制 。 明斯基等人 。 已经提出GaN的蚀刻机制可能类似于GaAs提出的机制 , 其中光生空穴参与Ga和As的氧化分解 。 p-GaN观察到的可忽略的蚀刻速率与先前报道的p-GaAs结果一致 , 其中“表面带弯曲”阻止了积累
空穴在半导体表面的移动抑制了氧化反应的发生 。
这些结果表明 , PEC蚀刻工艺对于氮化镓层的掺杂剂选择性蚀刻非常有用 。 已经进行了初步实验 , 其中p-n异质结构的垂直截面在浸入溶液中时暴露于紫外线辐射 。 如上所述 , 通过p型层上的镍接触垫与样品进行电连接 。 发生掩埋n型层的选择性蚀刻 , 产生顶部p型层的深底切 。 没有观察到p型材料的蚀刻 。 通过使用p型掺杂或更宽带隙材料的蚀刻停止层 , 选择性PEC蚀刻可能是实现平滑蚀刻表面的有效技术 。 此外 , 产生底切轮廓的能力对于器件制造是有用的 , 使用干法蚀刻技术不容易实现 。
结论
本文使用氢氧化钾溶液和宽面积汞灯照明对氮化镓层进行光增强湿蚀刻 , n+和NID氮化镓层的蚀刻率为17-20nm/分钟 , 而p-GaN没有观察到蚀刻 。 样品被未退火的钛金属所掩盖 , 而钛金属很容易用高频蚀刻法去除 。 掺杂剂选择性蚀刻的初步实验已经成功 , 并表明该工艺可能作为一种低损伤蚀刻技术对氮化镓器件的制造具有有用的应用价值 。
推荐阅读
- 新的文件格式帮助研究人员缩短DNA分析时间
- 2022 年12 个令人兴奋的里程碑事件
- 纳米晶体技术已成功应用于难溶性药物,以克服药物溶解度差的缺点
- 科学家成功地配制了,各种具有溶解和吸收行为优势的纳米晶体制剂
- 水不溶性药物由于溶解度低需要大量有机增溶剂,容易导致不良反应
- 斯坦福科学家用年轻人血液让老年人逆生长27%,或成延寿爆款
- 科学家证明了,纳米悬浮液中的真皮姜黄素纳米晶体,具有更好的皮肤渗透性
- 出乎意料!2021年全球平均温“重回”3年前,地球是不是降温了?
- 好消息!乳腺癌新药Enhertu(DS-8201)获FDA优先审查:疗效击败T-DM1







