作者:泛林集团
随着芯片制造商开始转向更先进的技术节点 , 愈发精细的特征成为了棘手的难题 。 其中一个主要难点是将芯片设计转到晶圆上的材料 , 因为当前的材料很快就无法满足精细度要求 。 为了能及时满足下一代器件的缩放要求 , 泛林集团推出了一项突破性的干膜光刻胶技术 。 要更好地了解该解决方案 , 我们需要首先了解图形化工艺和当前使用的光刻胶 , 之后再探讨该技术的潜在优势 。
图形化:创建芯片特征
高级芯片的制造可能需要经历数百个不同的步骤 , 因为其中的微观特征需要一层层地构建 。 光刻是其中最重要的工艺步骤之一——整个半导体制造过程中 , 需要不断的重复 , 再加上沉积和刻蚀 , 这些步骤将芯片的设计最终呈现在晶圆上 。
在光刻过程中 , 需要在晶圆上涂覆被称为光刻胶的光敏材料 , 然后利用光掩膜(包含透明和不透明区域的图案)有选择地让部分光刻胶暴露在光下 , 之后就可以针对外露的部分进行刻蚀 , 其他部分则仍受(正性)光刻胶覆盖和保护 。 这样的方法让我们能够在覆盖光刻胶的晶圆上刻出想要的一组特征 , 其尺寸和密度则由原始的器件设计图形决定 。
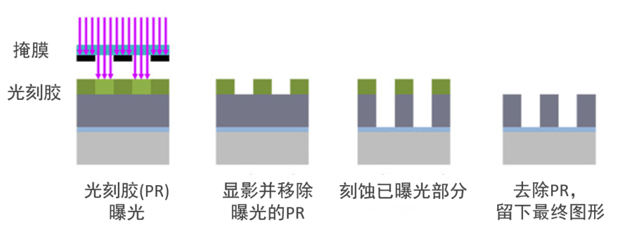
文章图片
芯片最小特征的尺寸和光刻过程中所用光的波长成正比 。 基于这一特性 , 波长更小的极紫外(EUV)光刻系统能够制造出比之前更精细的芯片特征 , 这一点类似于智能手机的屏幕分辨率——像素越小 , 显示精细度就越高 。
光刻胶的作用
光刻胶又称光致抗蚀剂 , 在光刻工艺中发挥着关键作用 。 优质的光刻胶需要具备高分辨率、灵敏度和较低的线边缘粗糙度(LER) 。
--分辨率是指可生成胶膜的最小尺寸 , 它由光刻胶材料与入射光子发生反应的能力决定 。
-- 线边缘粗糙度体现了最终特征与设计要求之间的差距;而LER数值为零时则代表沟槽壁达到了原子层级的完全垂直 。
-- 敏感度用来衡量创建特征所需的能量;光源强度越低 , 敏感度的要求就越高 。
同时做好以上三个参数是很困难的 , 因为它们会相互影响 , 提升其中一个参数往往意味着要牺牲至少另一个参数——即它们之间具有“RLS折衷关系” 。 为了更好地理解这种关系 , 我们首先需要了解光刻胶的工作原理 。
CAR光刻胶的原理
除了主要的聚合物基体以外 , 如今的化学放大光刻胶还包含很多其他成分 , 包括吸收剂、光致酸产生剂(PAGs)以及控制粘度、粘附性和稳定性的添加剂 。 光子(一种非常微小的光粒子)触及光刻胶时会引发改变材料结构的链式反应 , 使受反应影响的材料可溶性变高 , 随后可通过显影步骤将其移除 。 其中链式反应部分包括对初始光子的化学放大 , 指的是将光子转换成几个电子 , 并最终让每个入射光子产生几种光酸分子 。 采用了化学放大技术的材料就被称为化学放大光刻胶(CAR) 。
CAR的优势在于 , 只需提高每个光子产生的光酸分子数量就可以提升光刻胶的敏感度 。 但是更多的光酸分子意味着它们会愈发远离原始光子的位置 , 导致图像更加模糊、分辨率降低并提高线边缘粗糙度 。
虽然CAR在过去几十年间有了长足的进步 , 但到了5nm节点之后该技术领域已面临重大瓶颈 , 这就要求芯片制造商进行设计调整、半导体制造厂采用多次光刻过程以满足分辨率要求 。 为了能平衡EUV光刻技术的成本和设计难度 , 将其拓展至未来的工艺节点 , 我们需要一种创新的光刻胶解决方案 。
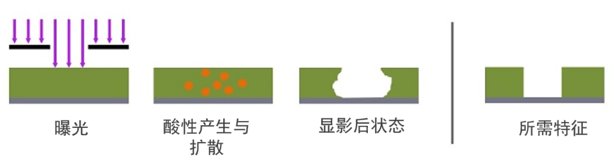
文章图片
干膜光刻胶解决方案
泛林集团与ASML和imec合作研发出了一种完全不同于旋转涂胶的突破性光刻胶技术 。 通过使用气相的反应前体 , 这种技术能够制出均匀且一致的薄膜 。
这项新的技术需要用干法沉积微小(<0.5nm)的金属有机粒子 , 而这种方法具有多项优势 。 首先 , 现在的EUV光源波长更短 , 产生的光子数量成倍减少 , 而这项新技术的重要特征就是可以通过高密度光敏粒子框架更加有效地捕获光子 。
此外 , 由于采用完全不同于CAR中链式反应的曝光机制 , 新技术的分辨率也更高 。 在国际光学工程学会(SPIE)的先进光刻技术研讨会上 , 我们展示了利用该技术在26nm间距上成功实现成像 , 最佳Z因子<1x10?? mJ nm3 。
干法沉积的一大特点是只需改变沉积和显影时间就可以改变光刻胶厚度 。 相比之下 , 改变旋转涂胶厚度的难度要大得多 , 因为它必然会涉及到粘度和表面粘附问题 , 最终不得不做出影响光刻性能的妥协 。 使用干式方法 , 我们就可以同时优化干膜厚度、光子吸收、转移刻蚀和底层粘附 , 从而摆脱必须权衡线边缘粗糙度、敏感度和缺陷/器件良率的难题 。
除打破RLS折衷关系以外 , 干膜技术还有其他优点 。 相对于旋转光刻胶 , 该技术不受粘度、化学保质期等限制因素的影响 。 由于不再需要添加用来控制粘附性或稳定性的添加剂 , 干法沉积获得的材料纯度更高 , 因此敏感度也更高 , 且重要的是非常适合之后的干法显影工艺 。
新的干法显影工艺在经过共同优化后能够最大限度减少线条和柱状图形塌陷 。 不受湿法工艺所固有的毛细作用力影响 , 干法显影的无塌陷工艺窗口期明显更长 。
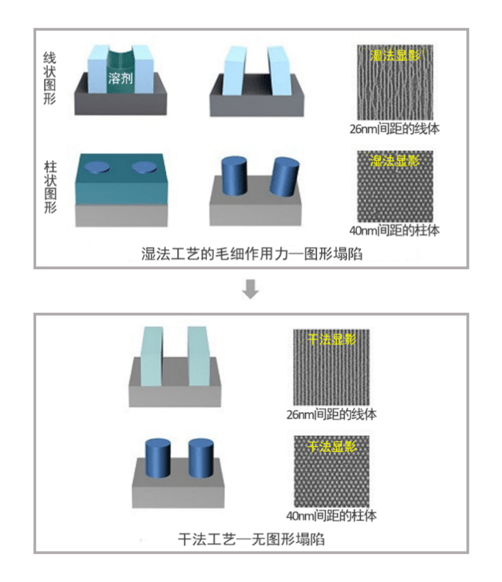
文章图片
【突破|泛林集团全新干膜光刻胶技术突破技术瓶颈,满足下一代器件的缩放需求】泛林集团的干膜光刻胶和显影技术能加速业界转向满足未来节点要求的EUV光刻应用 , 并且让面向高级逻辑和内存器件的持续缩放成为可能 。
推荐阅读
- Intel|英特尔放出i9-12900K平台PCIe 5.0 SSD演示 突破13GB/s传输速率
- 测试|北京:自动驾驶测试里程突破365万公里
- 文章|美媒文章:古人类领域2021年六大新突破
- 平台|[原]蚂蚁集团SOFAStack:新一代分布式云PaaS平台,打造企业上云新体验
- 市场|三星可折叠手机今年销量突破 800 万部,是去年的四倍
- 影像|京东零售集团CEO辛利军空降小米“跑进2022”活动直播间为米粉送福利
- 携手同行|陕西华晨教育集团携手同行,共赢未来
- IT|中国高铁运营里程突破4万公里:可绕地球赤道一圈
- IT|传三星集团洽谈收购美生物技术公司渤健 后者股价大涨逾9%
- 最新消息|紫光集团发布公告 公司重整计划已经获得表决通过







